На симпозиуме Technology Symposium компания TSMC продемонстрировала свои передовые разработки в области упаковки микрочипов. Одной из таких инноваций стала технология SoW-X. Благодаря решениям, подобным CoWoS, компании, такие как Nvidia, смогли преодолеть ограничения закона Мура и существенно повысить производительность своих чипов. TSMC объявила о выпуске CoWoS с увеличенным размером ретикля до 9,5x (в сравнении с текущими 5,5x в CoWoS-L), что позволит поддерживать до 12 стеков HBM. Планируется, что массовое производство начнётся в 2027 году и эта версия станет широко доступной.
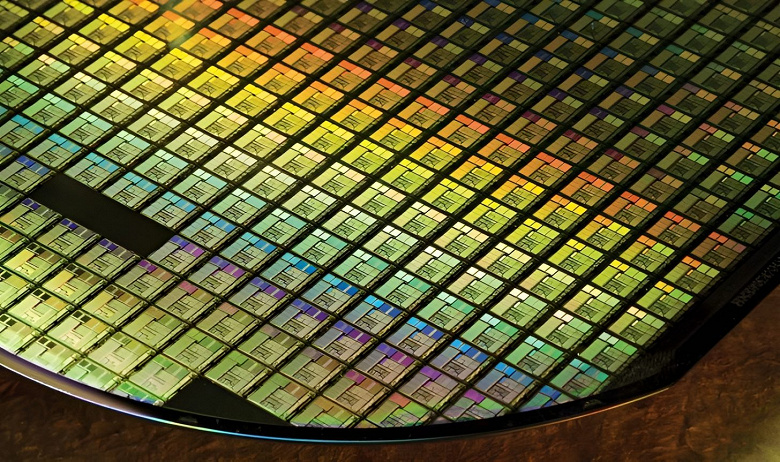
Однако в перспективе самым значительным достижением станет замена CoWoS на систему SoW (System-on-Wafer), способную увеличить размер ретикля в 40 раз и поддерживать 60 стеков HBM, что идеально подходит для AI-кластеров. Разработанная технология SoW-X обещает повысить вычислительную мощность в 40 раз по сравнению с действующим CoWoS, хотя все детали пока не раскрыты. Производство SoW и SoW-X намечено на 2027 год.
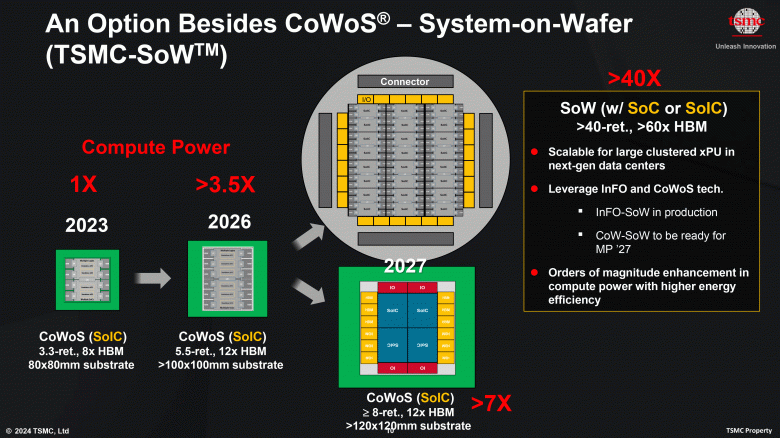
В области упаковки микрочипов, такой как CoWoS и SoW, размер ретикля отражает доступную площадь для обработки за один литографический цикл. Например, увеличение размера ретикля с 5,5x до 9,5x означает возможность размещения большего количества компонентов, таких как HBM-стеки, что ведет к повышению производительности и эффективности.
Источник: iXBT



